삼성전기, 세종 5공장 준공…가동 시점 '미지수' 부산·베트남 FC-BGA 생산 속도, 글라스 기판 준비 '착착'
김도현 기자공개 2024-05-17 07:55:02
이 기사는 2024년 05월 16일 16:33 thebell 에 표출된 기사입니다.
반도체 기판 생산능력(캐파)을 확장 중인 삼성전기가 속도 조절에 나선다. 반도체 업황이 반등하는 추세이나 아직 인공지능(AI) 분야를 제외하면 수요가 급증하는 수준은 아니기 때문이다.16일 업계에 따르면 삼성전기는 이달 세종사업장 내 반도체 패키지기판 5공장 외관 공사를 완료했다. 이곳에서는 ARM 기반 프로세서용 2.5차원(D) 패키지, 차세대 2.1D 패키지 등 고성능 반도체 맞춤형 아이템을 생산하게 된다.
2.5D는 실리콘 인터포저 위에 칩을 수평을 쌓는, 2.1D는 실리콘 인터포저를 내장하거나 재배선(RDL) 방식으로 회로를 새기는 패키징 방식이다.
다만 가동 시점은 정해지지 않은 상태다. 당초 올해 5월 중으로 건물을 지은 뒤 2층 일부까지 설비를 채워 연내 가동, 2층 나머지와 3층 설비는 2025년까지 반입할 계획이었다.

일정에 변동이 생긴 건 세종사업장이 다루는 품목 영향이다. 세종사업장은 스마트폰과 태블릿 등에 투입하는 애플리케이션프로세서(AP), 메모리, 5세대(5G) 안테나, 전장용 반도체 등에 필요한 패키지기판을 제조한다.
세부적으로는 플립칩(FC)-칩스케일패키지(CSP), 울트라씬 칩스케일패키지(UTCSP), 무선주파수(RF)-시스템인패키지(SiP) 등이다.
FC-CSP는 고집적 반도체와 기판을 FC 범프로 연결해 전기 및 열적 특성을 높인 것이 특징이다. 주로 스마트폰용 AP 등에 쓰인다. UTCSP는 칩과 패키지기판을 얇은 금선으로 연결하는 것으로 칩이 차지하는 면적이 전체 80%에 달한다. 모바일용 메모리 등 멀티칩 패키지(MCP)에 활용된다. RF-SiP는 하나의 기판에 여러 칩과 수동소자를 실장하는 모듈형태 기판으로 5G 모듈 등에 적용된다.
기존 1~2공장은 전공정(프론트), 3~4공장은 후공정(백엔드) 중심이다. 각각 회로 배선 구현, 표면 처리가 핵심이다.
신공장은 스마트팩토리로 구현해 사람의 개입을 최소화할 방침이다. 공정 미세화에 따라 이물질 등 침투를 막아 수율(완성품 중 양품 비율)을 높이고 비용은 낮추기 위함이다.
반도체 업계 관계자는 "AI 반도체 이외에 모바일, PC 등 반도체는 하반기 정도는 돼야 수요가 늘어날 것으로 보인다. 관련 공급망에 속한 업체들은 고객 주문 상황을 살피면서 캐파나 가동률을 조절하는 분위기"라고 설명했다.
반면 첨단 반도체 기판인 플립칩(FC)-볼그리드어레이(BGA) 생산라인이 조성된 부산사업장은 세종사업장보다 먼저 가동률이 높아질 것으로 관측된다. 서버용 FC-BGA 등 수요가 점차 늘어남에 따라 부산사업장도 활기를 띠는 흐름이다.
더불어 베트남에 마련한 FC-BGA 신규 라인은 2분기부터 매출이 발생할 것으로 예상된다. 앞서 삼성전기는 "베트남 신공장은 올해 초 제품 양산을 위한 고객 승인을 마치고 2분기부터 가동 시작하면서 매출이 발생할 것"이라고 밝혔다.
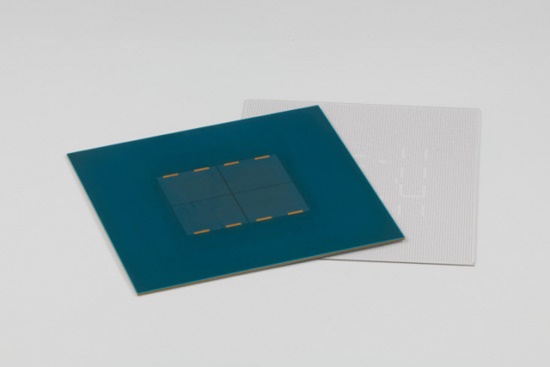
◇연내 글라스 기판 파일럿 라인 '셋업'
세종사업장은 5공장 말고도 주목받는 이유가 있다. 유리(글라스) 기판의 파일럿 라인이 세워지는 영향이다.
글라스 기판은 기존 플라스틱 기반의 반도체 기판을 유리 재질로 바꾼 제품이다. 온도에 따른 변형과 신호 특성이 우수해 미세화 및 대면적화에 적합하다는 평가다. AI 반도체 등 하이엔드 제품용으로 활용될 전망이다.
SKC, 인텔 등이 선제 대응에 나선 가운데 삼성전기와 LG이노텍 등도 발 빠르게 사업화를 진행 중이다.
올해 초 장덕현 삼성전기 사장은 "(글라스 기판은) 아직 누구도 양산해본 적이 없는 제품이다. 고객에게 시제품을 보여주는 단계고 2~3년 뒤 양산해볼 계획"이라고 언급한 바 있다.
삼성전기의 경우 연내 파일럿 라인을 마련하고 내년 중 샘플을 고객에 제공할 방침이다. 본격 양산 시기는 2026~2027년경으로 잡았다.
최근 고대역폭 메모리(HBM) 등에서 실리콘관통전극(TSV) 기술이 핵심으로 꼽힌다면 글라스 기판에서는 유리관통전극(TGV) 기술이 필수적이다. 각각 실리콘과 유리에 미세한 구멍을 뚫어 촘촘한 미세회로를 만드는 과정이다. 이를 위해 삼성전기는 켐트로닉스, 독일 LPKF 등과 협력하고 있는 것으로 전해진다.
삼성전기는 이르면 내후년부터 글라스 가핀 양산 체제를 갖출 예정이나 내부적으로 조심스러운 입장이다. 여전히 FC-BGA 등 플라스틱을 원재료로 하는 반도체 기판이 메인이고 글라스 기판 시장에 대한 평가가 엇갈리기 때문이다. 트렌드에 맞춰 대응 중이나 당장 글라스 기판을 전면에 내세우지는 않을 가능성이 크다.
< 저작권자 ⓒ 자본시장 미디어 'thebell', 무단 전재, 재배포 및 AI학습 이용 금지 >
관련기사
best clicks
최신뉴스 in 인더스트리
-
- [한미 오너가 분쟁]임주현 "임종윤과 다른 길, 해외투자 유치는 곧 매각"
- [i-point]미래산업, 용인 반도체 클러스터 L-벨트 이전
- [한미 오너가 분쟁]소액주주 만난 임주현, 핵심은 'R&D' "한미정신 지킨다"
- '나형균호' 오하임앤컴퍼니, 사업 다각화 고삐
- [i-point]휴림로봇, 일반공모 유상증자 청약률 196.5% 기록
- [i-point]부스터즈, 네이버 스마트스토어·자사몰 매출 전략 강화
- '탄소제로 대비' 대우건설, 환경 에너지 정조준
- [시큐리티 컴퍼니 리포트] 시큐아이, 빅3급 실적에도 '보안 거리 먼' 임원들 우려
- [i-point]엑스페릭스-퓨리오사AI, UAE 방문 '협력 강화'
- 성장 돌파구 모색 KT스카이라이프, AI·아마스포츠 공략
김도현 기자의 다른 기사 보기
-
- [Company Watch] '형님따라 반등' LX세미콘, 수익성 향상 계속
- [LX세미콘은 지금] 구본준 숙원 반도체, 산적한 미완의 과제
- [IR Briefing] '애플 공급망 입지 확대' LGD, 흑자전환 '눈앞'
- [IR Briefing] 'HBM 독점 위력' SK하이닉스, 6년 만에 영업익 5조↑
- [삼성·SK 메모리 레이스]괴물칩 '블랙웰' 양산 임박, HBM 판도 바뀐다
- [Company Watch]'애플 중국 공략 통했다' LG이노텍, 역대 최고 2분기 실적
- [토종 AI반도체 생존게임]팹리스 5형제 나란히 적자, 흑자·IPO 기대 '안 보인다'
- [토종 AI반도체 생존게임]'제2의 D램' 골든타임, 한국판 엔비디아 등장 갈림길
- [삼성·SK 메모리 레이스]'첨단 D램 생산지' 평택·이천, 후공정 라인 증설
- 삼성·어보브·가온칩스, 파운드리 이어 'AI 가전' 동맹



















